发布日期:2025-03-05 16:58:07
日立创新机器学习技术:精准捕捉10nm以下微小半导体缺陷
探索未来科技:日立革新机器学习精准定位纳米级半导体瑕疵
3月5日消息,日立于当地时间2月27日宣布,该公司已经研发出一种高灵敏度的半导体缺陷检测技术,借助机器学习的帮助能够检测到10纳米及更小尺寸的微小缺陷。此技术已在二月末的SPIE先进光刻与图案化2025学术会议上展示。
随着高性能芯片需求的持续增长,半导体制造商在生产过程中对质量控制的重视程度也在不断提升。制程的微缩使得能够影响芯片性能的缺陷尺寸门槛不断降低,从而对缺陷检测的灵敏度提出了更高的要求。日立的这项技术正是在这种背景下应运而生的。 这项技术的发展无疑为半导体行业提供了一个重要的解决方案。随着芯片复杂性的增加和尺寸的缩小,传统检测方法已经难以满足当前的需求。日立的新技术不仅提高了检测的精度,还可能大大缩短检测时间,这对于提高生产效率和产品质量至关重要。这标志着半导体行业在追求更高性能的道路上迈出了坚实的一步,同时也预示着未来在缺陷检测领域的更多创新可能性。
了解到,日立的机器学习缺陷检测技术主要包含两大部分,即图像重建对比和过度检测抑制:
检测系统首先通过对大量含有噪点的“人造”缺陷图像进行学习,以掌握微缺陷的数据特征;在实际应用中,系统会尝试将扫描电镜照片重建为无缺陷版本,并对原始图像与重建图像进行对比,以此来识别缺陷。
由于先进半导体制程的微缩,差异化功能电路和缺陷在图像上的区别越来越不明显。机器学习检测系统能够对电路布局进行分类,并依据电路特征调整灵敏度,从而将过度检测的现象降低约90%。
人工智能最新资讯

北京特大暴雨致30人遇难,城市警钟再响
2025-07-29 15:07:19

突破视觉边界:飞利浦27E3U7903挑战苹果Studio Display,5120x2880超清巨幕来袭
2025-07-29 15:02:04
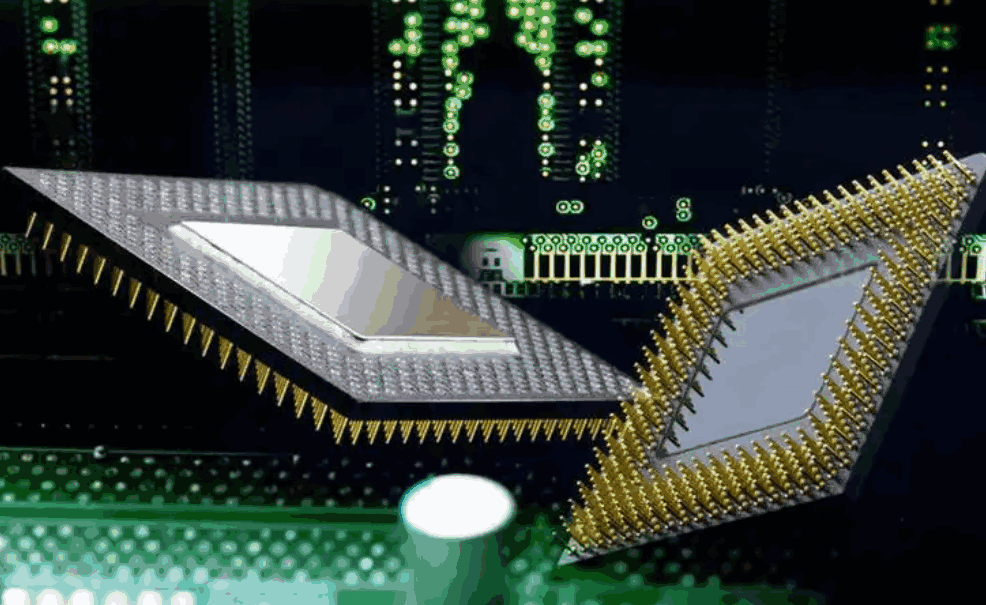
字节跳动紧急驰援京津冀:1000万元善款直击暴雨灾区
2025-07-29 14:59:58

抖音精选独家呈现:RoboMaster全国赛震撼启幕,科技与热血碰撞新高度
2025-07-29 14:55:05
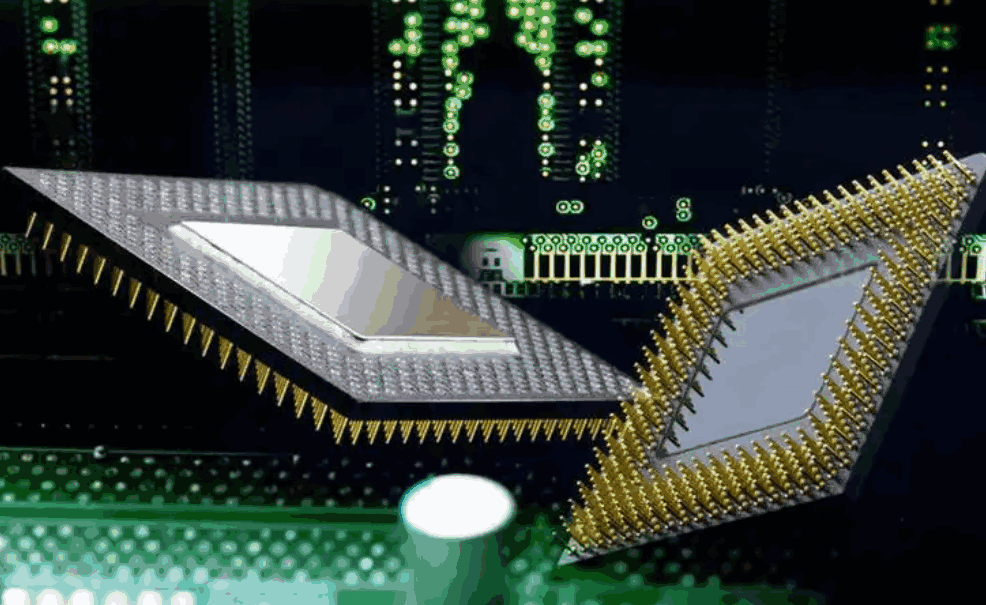
索尼 PlayStation 首款无线格斗手柄 FlexStrike 震撼官宣:2026 年引领游戏新纪元
2025-07-29 14:44:01

小米米家扫拖机器人 5 Pro 上线:AI三摄全景识别,国补后仅需 3399 元起
2025-07-29 14:42:47

自媒体乱象整治风暴:四类虚假信息成重点打击目标
2025-07-29 14:41:01

三星Galaxy Z Fold7:轻薄革命,折叠未来
2025-07-29 14:39:44

问界 M8 产品负责人:小订价格仅为预热,正式售价将8月揭晓
2025-07-29 14:36:10

爱高手AI学习机重磅来袭,开启就业教育新纪元
2025-07-29 14:35:51

骂游戏成流量密码?7天戒网瘾课收费6.68万引热议
2025-07-29 14:32:22

Claude Pro/Max限时新规上线:8月28日起,仅少数用户受影响
2025-07-29 14:32:15

联想6999元发布2025款斗战者战7000酷睿版:i7-14650HX + RTX 5060,国补后仅5599.2元引爆市场
2025-07-29 14:30:44

联想 ThinkPad S2 2in1 2025 首发:ARL-U 平台加持,翻转本+手写笔引领商务新体验
2025-07-29 14:30:08

苹果 iPhone 17 Pro 原型机首曝:横向矩阵设计引爆未来手机美学
2025-07-29 14:26:50

苹果下滑11%!三星狂飙38%,美国手机市场格局生变
2025-07-29 14:26:23

2025Q1安卓销量王者来袭:三星Galaxy A17首曝惊艳渲染图
2025-07-29 14:25:15

卫星电话关键时刻保命?村民靠华为手机上报险情引关注
2025-07-29 14:24:07

魅族22 Pro?黄质潘:22就是Pro!
2025-07-29 14:22:33

台积电资深研发副总罗唯仁退休:21年传奇征程画上句点
2025-07-29 14:20:13

微信QQ余额互转零手续费,问界M7重磅来袭,博世高管力挺车企效仿特斯拉华为
2025-07-29 14:19:32

《阿凡达3》首支预告震撼发布:灰烬族女王强势登场,燃爆科幻世界
2025-07-29 14:17:51

铭瑄RTX 5060 Ti iCraft OC 8GB评测:2K电竞新宠,性价比之王来袭
2025-07-29 14:15:15

华为Mate 80重磅来袭:eSIM+低轨卫星通信双加持,科技再突破
2025-07-29 14:13:33

印度成苹果iPhone最大制造地,生产良率略逊中国